что такое пороговое напряжение мдп транзистора
СОДЕРЖАНИЕ
Основные принципы
Если напряжение затвора ниже порогового напряжения (левый рисунок), транзистор «улучшенного режима» выключен, и в идеале нет тока от стока к истоку транзистора. Фактически, существует ток даже при смещении затвора ниже порогового ( допороговая утечка ) тока, хотя он невелик и экспоненциально изменяется с смещением затвора.
Если напряжение затвора выше порогового напряжения (правый рисунок), транзистор «улучшающего режима» включается из-за наличия большого количества электронов в канале на границе оксид-кремний, создавая канал с низким сопротивлением, в котором может происходить заряд. течь от слива к истоку. Для напряжений, значительно превышающих пороговое значение, такая ситуация называется сильной инверсией. Канал сужается, когда V D > 0, потому что падение напряжения из-за тока в резистивном канале уменьшает оксидное поле, поддерживающее канал, по мере приближения к стоку.
Эффект тела
Для полевого МОП-транзистора nMOS в режиме улучшения влияние тела на пороговое напряжение вычисляется в соответствии с моделью Шичмана-Ходжеса, которая является точной для более старых технологических узлов, с использованием следующего уравнения:
Зависимость от толщины оксида
Таким образом, чем меньше толщина оксида, тем ниже пороговое напряжение. Хотя это может показаться улучшением, оно не обходится без затрат; потому что чем меньше толщина оксида, тем выше будет подпороговый ток утечки через устройство. Следовательно, спецификация конструкции для толщины оксида затвора 90 нм была установлена на уровне 1 нм, чтобы контролировать ток утечки. Этот вид туннелирования называется туннелированием Фаулера-Нордхейма.
Температурная зависимость
Как и в случае, когда толщина оксида влияет на пороговое напряжение, температура влияет на пороговое напряжение КМОП-устройства. Расширение на части уравнения в эффекте тела раздела
Зависимость от случайного колебания примеси
Исследовательские работы проводятся с целью подавления флуктуации примеси, которая приводит к изменению порогового напряжения между устройствами, подвергающимися одному и тому же производственному процессу.
Расчет порогового напряжения МДП-структуры с учетом парциальных зарядов подвижных носителей заряда
Рубрика: Технические науки
Дата публикации: 16.02.2015 2015-02-16
Статья просмотрена: 1977 раз
Библиографическое описание:
Головяшкин, А. А. Расчет порогового напряжения МДП-структуры с учетом парциальных зарядов подвижных носителей заряда / А. А. Головяшкин, А. Н. Головяшкин. — Текст : непосредственный // Молодой ученый. — 2015. — № 4 (84). — С. 155-157. — URL: https://moluch.ru/archive/84/15649/ (дата обращения: 19.11.2021).
Для большинства элементов и приборов на основе МДП-структур одним из важнейших параметров является пороговое напряжение [1].
Точный расчет этого параметра затруднен в связи с неопределенностью значений встроенного заряда в диэлектрике и распределения поверхностных состояний на границе раздела диэлектрик — полупроводник. Поэтому для достижений расчетного значения используют подгонку параметра с помощью ионной имплантации [1]. Но одновременно с пороговым напряжением происходит изменение других параметров и характеристик структуры. Наиболее негативное влияние ионная имплантация оказывает на поверхностную подвижность носителей заряда, которая уменьшается с увеличением дозы. Это ухудшает функциональные возможности элементов. Снижение подвижности в МДП-транзисторе уменьшает крутизну передаточной характеристики, граничную рабочую частоту элемента, ухудшает статические и динамические характеристики. У приборов с зарядовой связью также возрастают потери информационного сигнала.
Снижение дозы ионной имплантации возможно за счет уточненного расчета значения порогового напряжения еще на ранних стадиях проектирования МДП-структуры. Для формирования структуры используют однородно легированную полупроводниковую подложку, поэтому достаточно рассмотреть одномерную модель.
Производители элементной базы под пороговым напряжением понимают значение напряжения на затворе, при котором в МДП-транзисторе возникает так называемый предпороговый ток, не превышающий определенного минимального значения [2]. Более универсальным, особенного на стадии расчета, является значение напряжения затвора, при котором поверхностный потенциал полупроводника соответствует началу сильной инверсии поверхности. При начале инверсии поверхностные концентрации электронов и дырок равны: ps=ns=ni. При начале сильной инверсии поверхностная концентрация неосновных носителей равна значению объемной концентрации основных носителей заряда. Тогда падение напряжения Vsc на приповерхностной области объемного заряда (ПООЗ) полупроводника должно быть равно:
где k — постоянная Больцмана; T — температура по шкале Кельвина; q — заряд электрона по модулю; ys — поверхностный безразмерный потенциал, отсчитанный от положения собственного уровня Ферми в нейтральном объеме; λ = p0/ni = ni/n0 — степень (уровень) легирования.
Значение ys, которое определяется равенством (1), задает начало сильной инверсии (yinv).
Теперь рассмотрим выражение для расчета порогового напряжения, которое часто используется в различных методиках и алгоритмах расчета:

где Vk — контактная разность потенциалов, равная разности работ выхода электрона из полупроводника и металла; Qист — заряд ПОПЗ; Qt — эффективный заряд поверхностных состояний; Qd — эффективный встроенный заряд диэлектрика.
Для идеальной МДП структуры значения Vk, Qист и Qd равны нулю.
Совершенствование технологии производства позволили уменьшить влияние неконтролируемых зарядов и производить расчет по модели, которая учитывает только контактную разность потенциалов. Заряд Qист рассчитывался в приближении резкого p-n перехода:

и используя равенство (1) окончательно получаем:

где N — эффективная концентрация ионизированной примеси в полупроводниковой подложке, определяющая объемную концентрацию основных носителей заряда; ε0 –диэлектрическая постоянная; εs — относительная диэлектрическая проницаемость полупроводника [2–3].
Для более корректного расчета порогового напряжения необходимо решить уравнение Пуассона с учетом заряда подвижных носителей. В результате первого интегрирования имеем следующее равенство:

и для полупроводника в равновесном состоянии: 
где 
Правило знаков для F(y) следующее: при 
Из уравнения (4) очевидно, что функция F(y) есть напряжённость электрического поля в ПООЗ с точностью до множителя kT/q. Используя теорему Гаусса, получим выражение для расчета поверхностной плотности заряда на границе полупроводник — диэлектрик:

Для расчета порогового напряжения через 


Теперь оценим, насколько оправдано предложенное усложнение. Для идеальной структуры Vk, Qd и Qt равны нулю. Тогда:

Для расчета возьмем типовые значения параметров кремниевых интегральных МОП — транзисторов при температуре 300К: толщина окисла 20 нм, λ = 10 3 …10 5 [1, 4]. Результаты приведены в таблице 1.
Абсолютная 

Параметр легирования λ


Полевые транзисторы. For dummies
Введение
Полевыми транзисторами называют активные полупроводниковые приборы, обычно с тремя выводами, в которых выходным током управляют с помощью электрического поля. (electrono.ru)
Определение не только подтвердило наши предположения, но и продемонстрировало особенность полевых транзисторов — управление выходным током происходит посредством изменения приложенного электрического поля, т.е. напряжения. А вот у биполярных транзисторов, как мы помним, выходным током управляет входной ток базы.
Еще один факт о полевых транзисторах можно узнать, обратив внимание на их другое название — униполярные. Это значит, что в процессе протекания тока у них участвует только один вид носителей заряда (или электроны, или дырки).
Три контакта полевых транзисторов называются исток (источник носителей тока), затвор (управляющий электрод) и сток (электрод, куда стекают носители). Структура кажется простой и очень похожей на устройство биполярного транзистора. Но реализовать ее можно как минимум двумя способами. Поэтому различают полевые транзисторы с управляющим p-n переходом и с изолированным затвором.
Вообще, идея последних появилась еще в 20-х годах XX века, задолго до изобретения биполярных транзисторов. Но уровень технологии позволили реализовать ее лишь в 1960 году. В 50-х же был сначала теоретически описан, а затем получил воплощение полевой транзистор с управляющим p-n переходом. И, как и их биполярные «собратья», полевые транзисторы до сих пор играют в электронике огромную роль.
Перед тем, как перейти к рассказу о физике работы униполярных транзисторов, хочу напомнить ссылки, по которым можно освежить свои знания о p-n переходе: раз и два.
Полевой транзистор с управляющим p-n-переходом
Итак, как же устроен первый тип полевых транзисторов? В основе устройства лежит пластинка из полупроводника с проводимостью (например) p-типа. На противополжных концах она имеет электроды, подав напряжение на которые мы получим ток от истока к стоку. Сверху на этой пластинке есть область с противоположным типом проводимости, к которой подключен третий электрод — затвор. Естественно, что между затвором и p-областью под ним (каналом) возникает p-n переход. А поскольку n-слой значительно уже канала, то большая часть обедненной подвижными носителями заряда области перехода будет приходиться на p-слой. Соответственно, если мы подадим на переход напряжение обратного смещения, то, закрываясь, он значительно увеличит сопротивление канала и уменьшит ток между истоком и стоком. Таким образом, происходит регулирование выходного тока транзистора с помощью напряжения (электрического поля) затвора.
Можно провести следующую аналогию: p-n переход — это плотина, перекрывающая поток носителей заряда от истока к стоку. Увеличивая или уменьшая на нем обратное напряжение, мы открываем/закрываем на ней шлюзы, регулируя «подачу воды» (выходной ток).
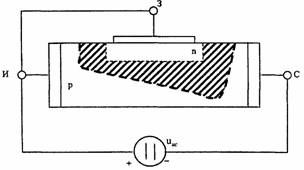

Даже при нулевом напряжении на затворе, между затвором и стоком существует обратное напряжение, равное напряжению исток-сток. Вот почему p-n переход имеет такую неровную форму, расширяясь к области стока.
Само собой разумеется, что можно сделать транзистор с каналом n-типа и затвором p-типа. Сущность его работы при этом не изменится.

Статические характеристики полевого транзистора с управляющим p-n-переходом
Выходной (стоковой) называется зависимость тока стока от напряжения исток-сток при константном напряжении затвор-исток. На рисунке — график слева.
На графике можно четко выделить три зоны. Первая из них — зона резкого возрастания тока стока. Это так называемая «омическая» область. Канал «исток-сток» ведет себя как резистор, чье сопротивление управляется напряжением на затворе транзистора.
Вторая зона — область насыщения. Она имеет почти линейный вид. Здесь происходит перекрытие канала в области стока, которое увеличивается при дальнейшем росте напряжения исток-сток. Соответственно, растет и сопротивление канала, а стоковый ток меняется очень слабо (закон Ома, однако). Именно этот участок характеристики используют в усилительной технике, поскольку здесь наименьшие нелинейные искажения сигналов и оптимальные значения малосигнальных параметров, существенных для усиления. К таким параметрам относятся крутизна характеристики, внутреннее сопротивление и коэффициент усиления. Значения всех этих непонятных словосочетаний будут раскрыты ниже.
Третья зона графика — область пробоя, чье название говорит само за себя.
С правой стороны рисунка показан график еще одной важной зависимости — стоко-затворной характеристики. Она показывает то, как зависит ток стока от напряжения затвор-исток при постоянном напряжении между истоком и стоком. И именно ее крутизна является одним из основных параметров полевого транзистора.
Полевой транзистор с изолированным затвором
Такие транзисторы также часто называют МДП (металл-диэлектрик-полупроводник)- или МОП (металл-оксид-полупроводник)-транзисторами (англ. metall-oxide-semiconductor field effect transistor, MOSFET). У таких устройств затвор отделен от канала тонким слоем диэлектрика. Физической основой их работы является эффект изменения проводимости приповерхностного слоя полупроводника на границе с диэлектриком под воздействием поперечного электрического поля.
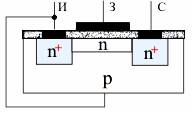
Если при нулевом напряжении на затворе подать напряжение исток-сток, то по каналу между ними потечет ток. Почему не через кристалл? Потому что один из p-n переходов будет закрыт.
А теперь подадим на затвор отрицательное относительно истока напряжение. Возникшее поперечное электрическое поле «вытолкнет» электроны из канала в подложку. Соответственно, возрастет сопротивление канала и уменьшится текущий через него ток. Такой режим, при котором с возрастанием напряжения на затворе выходной ток падает, называют режимом обеднения.
Если же мы подадим на затвор напряжение, которое будет способствовать возникновению «помогающего» электронам поля «приходить» в канал из подложки, то транзистор будет работать в режиме обогащения. При этом сопротивление канала будет падать, а ток через него расти.
Рассмотренная выше конструкция транзистора с изолированным затвором похожа на конструкцию с управляющим p-n переходом тем, что даже при нулевом токе на затворе при ненулевом напряжении исток-сток между ними существует так называемый начальный ток стока. В обоих случаях это происходит из-за того, что канал для этого тока встроен в конструкцию транзистора. Т.е., строго говоря, только что мы рассматривали такой подтип МДП-транзисторов, как транзисторы с встроенным каналом.
Однако, есть еще одна разновидность полевых транзисторов с изолированным затвором — транзистор с индуцированным (инверсным) каналом. Из названия уже понятно его отличие от предыдущего — у него канал между сильнолегированными областями стока и истока появляется только при подаче на затвор напряжения определенной полярности.
Итак, мы подаем напряжение только на исток и сток. Ток между ними течь не будет, поскольку один из p-n переходов между ними и подложкой закрыт.
Подадим на затвор (прямое относительно истока) напряжение. Возникшее электрическое поле «потянет» электроны из сильнолегированных областей в подложку в направлении затвора. И по достижении напряжением на затворе определенного значения в приповерхностной зоне произойдет так называемая инверсия типа проводимости. Т.е. концентрация электронов превысит концентрацию дырок, и между стоком и истоком возникнет тонкий канал n-типа. Транзистор начнет проводить ток, тем сильнее, чем выше напряжение на затворе.
Из такой его конструкции понятно, что работать транзистор с индуцированным каналом может только находясь в режиме обогащения. Поэтому они часто встречаются в устройствах переключения.
Условные обозначения транзисторов с изолированным затвором следующие:

Здесь
а − со встроенным каналом n- типа;
б − со встроенным каналом р- типа;
в − с выводом от подложки;
г − с индуцированным каналом n- типа;
д − с индуцированным каналом р- типа;
е − с выводом от подложки.
Статические характеристики МДП-транзисторов
Те же характеристики для транзистора с идуцированным каналом:
Экзотические МДП-структуры
Чтобы не запутывать изложение, хочу просто посоветовать ссылки, по которым о них можно почитать. В первую очередь, это всеми любимая википедия, раздел «МДП-структуры специального назначения». А здесь теория и формулы: учебное пособие по твердотельной электронике, глава 6, подглавы 6.12-6.15. Почитайте, это интересно!
Общие параметры полевых транзисторов
Схемы включения
Как и биполярный, полевой транзистор можно рассматривать как четырехполюсник, у которого два из четырех контактов совпадают. Таким образом, можно выделить три вида схем включения: с общим истоком, с общим затвором и с общим стоком. По характеристикам они очень похожи на схемы с общим эмиттером, общей базой и общим коллектором для биполярных транзисторов.
Чаще всего применяется схема с общим истоком (а), как дающая большее усиление по току и мощности.
Схема с общим затвором (б) усиления тока почти не дает и имеет маленькое входное сопротивление. Из-за этого такая схема включения имеет ограниченное практическое применение.
Схему с общим стоком (в) также называют истоковым повторителем. Ее коэффициент усиления по напряжению близок к единице, входное сопротивление велико, а выходное мало.
Отличия полевых транзисторов от биполярных. Области применения
Где применяются полевые транзисторы? Да практически везде. Цифровые и аналоговые интегральные схемы, следящие и логические устройства, энергосберегающие схемы, флеш-память… Да что там, даже кварцевые часы и пульт управления телевизором работают на полевых транзисторах. Они повсюду, %хабраюзер%. Но теперь ты знаешь, как они работают!
Что такое пороговое напряжение мдп транзистора
Физической основой работы полевого транзистора со структурой металл – диэлектрик – полупроводник является эффект поля. Напомним, что эффект поля состоит в том, что под действием внешнего электрического поля изменяется концентрация свободных носителей заряда в приповерхностной области полупроводника. В полевых приборах со структурой МДП внешнее поле обусловлено приложенным напряжением на металлический электрод – затвор. В зависимости от знака и величины приложенного напряжения могут быть четыре состояния области пространственного заряда (ОПЗ) полупроводника – обогащение, обеднение, слабая и сильная инверсии. Полевые транзисторы в активном режиме могут работать только в области слабой или сильной инверсии, т. е. в том случае, когда инверсионный канал между истоком и стоком отделен от квазинейтрального объема подложки областью обеднения.
Рис. 14.25. МДП‑транзистор с индуцированным каналом в равновесных условиях:
а – напряжение на затворе отсутствует V G = 0;
б – напряжение на затворе больше порогового напряжения V G > VT ( V G 0)
Таким образом, МДП‑транзистор является сопротивлением, регулируемым внешним напряжением. К нему даже в большей степени, чем к биполярным приборам, подходит историческое название «транзистор», т. к. слово «transistor» образовано от двух английских слов – «transfer» и «resistor», что переводится как «преобразующий сопротивление».
Лекция 1 (принести на лекцию литературу и экспонаты)
Пороговое напряжение МДП-транзисторов
Общие вопросы (Наилучший первоисточник — Маллер и Кейминс, ЭИС, с. 450–565)
Пороговое напряжение — один из основных параметров МДП-приборов.
Чтобы не рисовать зонных диаграмм (их можно найти в любом учебнике), мы введем несколько положений, которые более или менее очевидны.
1. Нормальный МДП-транзистор представляет собой 3-слойную структуру типа металл (Al) — диэлектрик (SiО2) — полупроводник (Si), либо нечто подобное. Материалы каждого из этих слоев имеют различные работы выхода и, следовательно, различные уровни Ферми.
2. Если все три слоя прилегают друг к другу достаточно плотно и границы раздела не содержат зарядов, то при отсутствии внешних напряжений все три слоя придут к одинаковому уровню Ферми. Выравнивание УФ в различных материалах происходит путем переноса отрицательных зарядов из слоев с более высокими УФ (меньшая работа выхода) в слои с более низкими УФ (бόльшая работа выхода).
Может показаться странным, что в МОП-структуре заряды могут переноситься через окисел, который является почти идеальным изолятором. Действительно, если при изготовлении такой структуры никаких цепей переноса заряда между металлом (за исключением окисла) не было, то эти материалы могут оставаться в неравновесном состоянии (т.е. с различными УФ) достаточно долгое время. Однако практически в каждой МОП-структуре есть какая-то цепь для передачи заряда, которая обладает намного большей проводимостью по сравнению с окислом. Поэтому можно считать, что между металлом и полупроводником существует электродинамические равновесие.
Лекция 21
3. В нашем случае отрицательный заряд из алюминия переносится в кремний, так как для Al работа выхода на 0,8 эВ меньше, чем для Si (qM – qS = 4,1 – 4,9 эВ). Тогда на поверхности металла образуется положительно заряженная плоскость, а в приповерхностной области кремния — изгиб зон. Данная ситуация похожа на обычный контакт «металл-полупроводник», но есть и существенные отличия:
В реальных МДП-транзисторах нужно учитывать заряд в пленке SiО2 и заряд поверхностных состояний в Si, наличие которых влияет на распределение и напряженность электрического поля в структуре. В SiО2 обычно существуют положительные заряды, обусловленные ионами калия, натрия и др., поэтому поле на границе раздела Si-SiО2 дополняется положительным зарядом в диэлектрике и таким же отрицательным зарядом электронов, скапливающихся у его поверхности. Этот заряд мы обозначим как Qss (заряд поверхностных состояний).
выхода металл-полупроводник, т.е. –0,8 В (р-подложка). С учетом Qss эта к.р.п. (так называемое напряжение спрямления зон, где оба слагаемых отрицательны) равна
(для n-канальных приборов способствует понижению Uпор)

инверсной, нужно не только скомпенсировать
полупроводник в канале, но еще и прибавить
поля, чтобы электроны получили господство
над дырками, т.е. создать в канале электрон-
ную проводимость вместо дырочной. Заряды,
которые создают эти поля, хорошо видны на
приводимой рядом диаграмме:
Q = qNa — плотность заряда акцепторов в ОПЗ,
ширину которой легко рассчитать при U = 2VFS
(превращает полупроводник из р-типа в n-тип,
отгоняя дырки на расстояние не менее );
Qn — плотность поверхностного заряда
электронов в канале под затвором — паспортная величина для данной технологии;
относительно середины запрещенной зоны;
Напряжение, создающее указанный заряд под затвором, называется напряжением изгиба зон и выражается как
Теперь можно записать полную формулу для порогового напряжения:
Таким образом, для каждого члена уравнения (1) явно просматривается соответствующий физический механизм.
1. При использовании формулы (1) следует помнить, что ее 1-е и 2-е слагаемые отрицательны.
2. Материал здесь представлен очень кратко и без доказательств, на самом деле вся теория намного сложнее. Есть много вариантов формулы (1) в зависимости от записи напряжений зон и выражений для зарядов. Это связано с типом МОП — р— и n-канальные с индуцированным и встроенным каналом.
Способы уменьшения порогового напряжения
Данная проблема обычно возникает в случае р-канальных МДП-транзисторов.
Один из способов — применение поликремниевых затворов, позволяющих обеспечить не только малую емкость перекрытия, но и малое пороговое напряжение: 1–2 В вместо обычных 2,5–3,5 В. Это связано с тем, что материал затвора и подложки здесь один и тот же — кремний. Следовательно, к.р.п. между ними равна нулю, что приводит к уменьшению порогового напряжения. Примерно тот же результат дает использование молибденового затвора.
Помимо к.р.п., для уменьшения порогового напряжения можно варьировать и другими параметрами (см. ф-лу (1)). Поскольку Uпор возрастает с увеличением степени легирования и с увеличением толщины подзатворного диэлектрика, то следует использовать умеренное легирование и тонкий диэлектрик. Можно заменить тонкий окисел SiO2 тонким напыленным слоем нитрида кремния Si3N4, у которого диэлектри-ческая проницаемость ( 7) примерно в полтора-два раза больше, чем у SiO2 ( 4). Это приводит к увеличению удельной емкости C0, а значит, к уменьшению соответствующих слагаемых порогового напряжения. Нитрид кремния в составе подзатворного диэлектрика дает и другие преимущества — меньшие шумы, большую временную стабильность ВАХ и повышенную радиационную стойкость МДП-транзисторов.
Сочетая перечисленные методы, можно обеспечить пороговое напряжение практически любой сколь угодно малой величины. Правда, слишком малые (0,5–1 В и менее) в большинстве случаев неприемлемы по схемотехническим соображениям (малая помехоустойчивость).